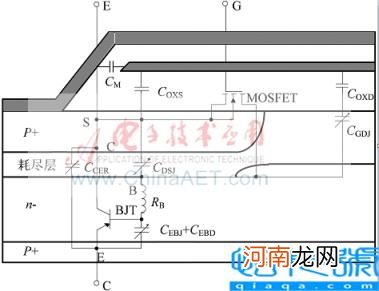
文章插图
图2 IGBT芯片的典型内部结构
2 铝键合线脱落故障的影响
由于功率波动等因素造成铝键合线脱落故障时,首先会改变其自身的杂散电阻和杂散电感 。门-射极电压与终端电容有着直接的关系,所以铝键合线全部脱落会影响终端电容,进而又影响门-射极电压 。
2.1 键合线脱落对门极杂散阻抗的影响
铝键合线是实现电连接的关键,通常为几根并联,每根键合线上由杂散电阻和杂散电感串联而成,如图3 。当部分键合线脱落、断裂或翘曲时,并联根数减少,铝键合线的等效杂散电感和杂散电阻增大 。
图3 杂散电阻和杂散电感等效电路
铝键合线故障也会影响终端电容,大电流的IGBT模块中每个单元通常由两个或更多IGBT芯片并联,图4为IGBT芯片的门极等效电路 。CGC和CGE是影响门极电压的主要参数,CCE的影响可忽略 。
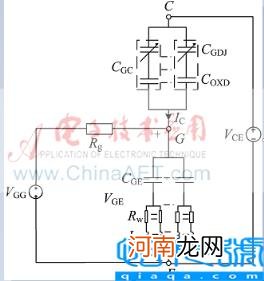
文章插图
图4 IGBT芯片门极等效电路
CGE计算公式为:
式中,AGE表示栅极多晶硅与发射极的金属重叠面积,dOX_GE表示他们之间的氧化层厚度,分别为真空介电常数和氧化层介电常数 。铝键合线全部脱落导致CGE减小 。
米勒电容CGC由COXD和CGDJ组成,计算公式分别为:
由公式可知CGDJ的值与VCE有关,因此在开通暂态过程中门-集极等效电容CGC并不是固定的值:
其中,AGD为IGBT芯片中MOSFET部分门-漏极交叠面积;q为电子电荷;NB为基区的掺杂浓度;εsi为硅的介电常数 。由于键合线全部脱落会使AGD减小,CGDJ和COXD随之减小,因此CGC减小 。
由上述分析可知,铝键合线部分脱落影响其等效杂散电阻和杂散电感,全部脱落后还会影响其等效杂散电容值 。又由于栅极等效电容与铝键合线电阻数量级上的差异,铝键合线全部脱落时,杂散电容变化对门极电压的影响占主导 。
2.2 杂散阻抗变化对门极电压波形的影响
IGBT模块杂散参数的变化导致门极开通电压波形发生改变 。根据VCE和VGE的变化可将IGBT的开通暂态过程分为图5所示的3个阶段:

文章插图
图5 IGBT器件开通暂态过程
阶段1(t1<t<t2):门极电压VGE开始上升但还未达到VGE(th),IGBT器件仍然处于关断状态 。门极电流给CGE和CGDJ充电,充电时间常数为τ=(Rw+Rg)(CGE+CGDJ) 。铝键合线部分故障杂散电阻增大,因此门极电压上升时间增大,上升速度减缓;芯片失效导致CGE减小,即门极回路内部杂散电容减小,所以门极电压上升时间减小,上升速度加快 。
阶段2(t2<t<t3):门极电压超过VGE(th),IGBT器件导通 。米勒电容CGC的存在,使得VGE出现米勒平台期,恒流源全部向CGC充电,因此米勒平台持续时间与CGC有关 。键合线全部脱落导致CGC减小,所以米勒平台持续时间会缩短 。捕捉米勒平台需要示波器具有很高的分辨率 。
阶段3(t3<t<t4):VCE下降至通态饱和压降,VGE逐渐上升至稳态值 。由式(3)可知,CGC=COXD为常数 。同阶段一,铝键合线部分故障VGE上升速度减慢,芯片失效时VGE上升速度加快 。
综上可知,第一阶段和第三阶段具有相同的变化规律,故在未能捕捉到米勒平台的情况下,可将第一、三阶段联合起来分析 。
3 实验测试及结果
在实验室模拟实际工况下功率循环等因素造成IGBT器件铝键合线故障 。研究铝键合线脱落过程中门极电压的变化规律 。
图6为开关特性测试电路,Vdc=450 V,驱动电压高电平+15 V,频率为10 kHz,负载阻抗为3 mH,20 Ω,栅极电阻Rg=10 Ω,示波器采样频率为1.25 GS/s 。测量铝键合线正常和分别脱落1-6根时IGBT模块的门极开通电压VGE,图7为正常和铝键合线发生脱落故障时门极开通电压波形比照图 。
- 慕斯蛋糕是什么材料做的
- 生日蛋糕能放几天
- 注册亚马逊全球开店 注册亚马逊全球开店需要什么材料?
- 周公解梦梦见各种水果 周公解梦梦见各种水果树
- 各种耳机的正确戴法图解 蓝牙耳机怎么戴才正确
- 亳州接地棒 接地棒用什么材料最好
- 无纺布是什么材料做的
- 新浪微博认证 新浪微博认证无需材料
- 炖五花肉的材料步骤 电压力锅炖肉怎么做
- 管材料的静液压试验 不锈钢管静压试验